Разработан метод наноразмерной визуализации напряжений в кристаллических решётках эпитаксиальных плёнок
Изначально метод птихографии («птихо» — «складной» с греческого) был разработан для повышения разрешающей способности просвечивающего электронного микроскопа. Для этого было решено отказаться от использования объектива, представляющего собой в случае электронного микроскопа набор магнитных линз, которые, по мнению создателей, и являются основной причиной снижения разрешающей способности метода.
Вместо этого в новом приборе изображение формируется благодаря компьютерной реконструкции рассеянных электронных волн, прошедших через образец. Иными словами,
в основе его работы лежит определение фазы рассеянной электронной волны для идентификации местоположения атома в образце, от которого она и пришла. В результате создателям птихографического метода удалось добиться значительного повышения разрешающей способности электронного микроскопа — в пять с лишним раз. Более того, есть мнение, что дальнейшее развитие этой технологии позволит достичь разрешения в 1/10 диаметра атома.
Ну а новый дифракционный метод, созданный в Аргоннской национальной лаборатории и IBM с помощью адаптации птихографии для случая когерентного нанофокусированного жёсткого рентгеновского излучения, позволяет визуализировать (в терминах дифракции рентгеновских лучей) поля напряжённости кристаллической решётки эпитаксиальных плёнок в невозмущённых граничных условиях.
Рассматриваемая работа, опирающаяся как на внутренние размерные эффекты (intrinsic size effects), так и на внешние граничные условия, делает реальностью неразрушающие исследования структурных особенностей материалов в нанометровом масштабе, когда проведение теоретических расчётов и практических измерений, а также установление контроля над возникающими напряжениями является крайне трудной задачей.
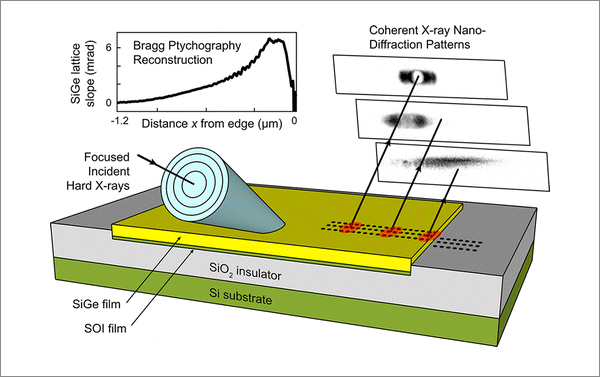 Рис. 1. Прототип устройства и схема эксперимента (иллюстрация ACS).
Рис. 1. Прототип устройства и схема эксперимента (иллюстрация ACS).
Нанофокусированная рентгеновская птихография брэгговских отражений обеспечивает эффективную визуализацию искажений кристаллической решётки в тонких плёнках без разрушения исследуемого образца. А использование когерентного нанофокусированного пучка жёстких рентгеновских лучей позволяет достигать разрешений, меньших 20 нм.
В качестве практического примера исследователи построили профиль напряжений в кристаллической структуре эпитаксиальной плёнки SiGe на SOI-подложке (кремний на изоляторе), являющейся источником стресса (ввиду отличного от SiGe значения параметра кристаллической решётки).
Подробнее о результатах эксперимента и основах нового метода рассказывается в журнале Nano Letters.
- Источник(и):
- Войдите на сайт для отправки комментариев
 Сайт о нанотехнологиях #1 в России
Сайт о нанотехнологиях #1 в России