Проблемы измерений размеров в микроэлектронной технологии (метрологии?)

Об авторе:
Никитин Аркадий Викторович
рожд. 07-01-1936, Лен. Гос. Универ. 1958 (Химия), канд. физ.-мат. наук 1963, (Кристаллография); докт. физ.-мат. наук.1992 (Микроэлектроника). С 1993г. Действительный член Академик (Общественной) Российской Метрологической Академии. Более 20 авторских свидетельств и патентов, более 120 печатных работ в отеч. и зарубежн. изданиях, в т.ч. 1 книга (в соавторстве). Лауреат Президентской стипендии для учёных 1994 г.
Введение
Место метрологии линейных размеров в технологии современных интегральных схем.
По общему признанию ключевыми операциями изготовления современной микроэлектронной продукции являются литографические процессы. Многолетние наблюдения свидетельствуют, что в общем объеме затрат на выпуск интегральных схем около 35% приходится на долю операций фотолитографии. Неотъемлемой частью этих операций считаются контрольные процедуры, проводимые для контроля качества литографии и отбраковки пластин и модулей, не соответствующих техническим требованиям. На эти контрольные операции приходится до 5% стоимости самих литографических процессов, т.е. 1.5 – 1.7% общих расходов микроэлектронного производства.
Обычно контрольно-измерительные операции проводятся для отбраковки изделий по соображениям:
- дефектности литографического рисунка,
- совмещаемости технологических слоев и
- размеров реализованных элементов схем.
Т.о. на долю измерений и контроля размеров (пункт с) можно отнести не менее 0.3 – 0.5% всех затрат производства. Какова эта часть затрат в абсолютных цифрах?
Годовой оборот совокупного мирового производства интегральных схем составляет величину, порядка 100 млрд. долларов. Десятая часть процента от этой суммы выражается числом примерно 100 млн. USD. Т.о. по осторожным оценкам около 250 – 300 млн. долларов затрачивается ежегодно в развитых странах на проведение операций измерения размеров.
На крупных предприятиях с массовым выпуском продукции круглосуточно работают десятки и даже сотни (например, на TSMC – Тайвань) специализированных измерительных электронных микроскопов, занятых исключительно на операциях измерения размеров.
Понятно, что целесообразность столь значительных затрат на метрологическое сопровождение производства интегральных схем зависит от того, насколько достоверны могут быть результаты измерений; насколько обоснованными оказываются решения о забраковании (либо признания годными) изделий, принятые на основе таких измерений.
Особенности измерений размеров в нанометровом диапазоне.
Главной особенностью измерений объектов такого рода является предельная малость измеряемых размеров и связанная с этим необходимость использования микроскопа (по большей части электронного) в качестве инструмента сравнения. В этих случаях мы измеряем фактически не физический объект – элемент интегральной схемы, но лишь его увеличенное изображение. Такие измерения относят к косвенным. Косвенные измерения часто проводятся на практике, но достоверность результатов обеспечивается только тогда, когда хорошо установлены законы, связывающие непосредственно измеряемое свойство со свойством, измеряемым косвенным путем. Пример: измерить величину тока в электрической цепи можно без ее разрыва – измеряя падение напряжение на калиброванном резисторе, а для пересчета измеренного напряжения в ток используется известный закон Ома.
В современной микроэлектронной технологии измерительным устройством служит почти исключительно сканирующий электронный микроскоп SEM. В практике косвенных SEM-измерений место закона Ома должен был бы занять закон, связывающий физический объект и его SEM-изображение. К сожалению, такой закон не установлен. Подобная ситуация не является особенностью лишь сканирующей электронной микроскопии. В равной мере она свойственна и другим микроскопическим методам: всем разновидностям оптической микроскопии, просвечивающей электронной микроскопии, сканирующей туннельной и атомно-силовой микроскопии. Что касается SEM-методов, то, несмотря на кажущуюся «очевидность» и «наглядность» SEM-изображений, они не передают истинной геометрии объекта. Картинка, т.е. распределение яркости на экране (снимке), соответствует (и то с большими оговорками!) распределению точечного коэффициента вторичной электронной эмиссии (ТКВЭЭ) по поверхности объекта. Конечно, ТКВЭЭ зависит от состава и геометрии объекта сканирования и таким образом все же как то отображает физические свойства и геометрию объекта, но это отображение управляется куда более сложными (и пока что не установленными) законами, чем закон Ома. Это и составляет фундаментальное препятствие в развитии SEM-метрологии нанометрового диапазона. О поисках паллиативных решений в этой области пойдет речь ниже
Часть I
1. Метрологические проблемы микро- и нано-электроники.
Динамика развития микроэлектронной технологии такова, что согласно Roadmap [1], уже в настоящее время промышленностью осваиваются СБИС с проектными нормами 32 нанометра или менее. Точность измерений размеров на подобных изделиях в процессе их изготовления (межоперационные измерения – in process control) должна быть экстремально высокой, а допустимая погрешность оценивается величиной 0.30 – 0.15 нанометра (3 сигма) [1]. Заметим, что проблема заключается не в собственно возможности измерять столь малые объекты, а в достижении требуемой точности. Для решения этой проблемы следует проанализировать источники погрешностей, свойственные имеющимся методам измерений. Примем, что сканирующая электронная микроскопия сохранит доминирующее положение и в предстоящие годы. Общепринятая схема процесса измерений с использованием SEM представлена на рисунке 1.
При использовании стратегии измерений, иллюстрируемой этим рисунком, предполагается, что размер L любого объекта может быть вычислен как произведение двух величин:
- размера этого объекта, выраженного в пикселях (Lp) и найденного в процессе выполнения работ в левой ветви рисунка, и
- расстояния между пикселями («длину» пикселя – Pixel Length, PL), выраженную в абсолютных единицах и вычисляемую в соответствии с правой ветвью рисунка 1:
Из сказанного понятно, что существует два основных источника погрешностей измерений:
- погрешность собственно процесса измерений размера (в писелях) по SEM-изображению, связанная в основном с нерешенной проблемой локализации краев измеряемого объекта – левая ветвь; и
- погрешности, вносимые в результат за счет неточностей операции калибровки увеличения SEM-измерителя (цены пикселя PL) - правая ветвь.
Указанные погрешности в конечном счете лимитируют итоговую точность результатов. Проведенный анализ свидетельствует, что эти погрешности, так же, как и итоговая погрешность измерений в целом, в значительной мере зависят от условий проведения измерений
Так, при проведении построчных измерений только одна – обусловленная шумами видеосигнала – погрешность может достигать 2.0 нм (3σ). Лишь статистическое усреднение индивидуальных результатов позволяет снизить погрешность среднего до приемлемых величин. Представление об источниках погрешностей и их взаимодействии может дать рисунок 2.
2. Источники погрешностей. Метрология в плену упрощающих идеализаций.
2.1. Погрешности калибровки увеличения.
В общем бюджете погрешностей на долю операций калибровки увеличения резонно положить не менее трети допуска на размеры. В частности, чтобы обеспечить требуемую точность измерений элементов СБИС с проектными нормами 65 нм (±0.43 нм, или 0.7% по критерию 3 сигма “for printed and physical lines”[1]), необходимо снизить погрешность увеличения SEM до уровня ±(0.2 – 0.3)% (3σ). Достигнутая в настоящее время погрешность калибровки измеряется единицами процентов для указанного диапазона размеров. Только одна эта погрешность “съедает“ весь ресурс погрешностей измерений, допустимый по Roadmap.
2.1.1. Традиционная постановка задачи.
Обычной задачей калибровки увеличения SEM является как можно более точное определение увеличения М. В некоторых моделях измерительных SEM в качестве калибруемой величины используется размер поля зрения микроскопа G. Использование масштаба М либо размера поля зрения G в качестве калибруемой величины нельзя признать удачным, т.к. при этом молчаливо предполагается, что равным участкам изображения отвечают равные участки объекта. Это предположение в принципе ошибочно, поскольку в любом реальном микроскопе системы сканирования всегда в той или иной мере несовершенны, в частности, нелинейны. Представление о линейности разверток SEM, так же, как следующие из него выводы, касающиеся увеличения M либо размеров поля зрения G, являются упрощающей идеализацией, не имеющей под собой реальных оснований. Нелинейность разверток SEM проявляется в том, что увеличение микроскопа оказывается не константой; оно меняется по полю зрения вдоль направления сканирования. Возникает необходимость введения понятия локального увеличения, и соответственно – локального значения длины пикселя. Теперь вместо константы PL мы должны использовать функцию PL(i), где i – номер пикселя в строке. Поэтому любое измеренное по SEM-изображению расстояние между пикселями 1 и 2, т.е. Li2 – i1 уже не может быть вычислено по формуле (1). Эта формула должна быть изменена:

Нам неизвестны конкретные модели или экземпляры измерительных SEM, которые обеспечивали бы вполне линейное сканирование при различных амплитудах (увеличениях) и скоростях разверток. Все измерительные SEM в той или иной мере нелинейны, но не аттестуются по этому параметру. Некоторые из них характеризуются нелинейностью в несколько процентов. Эксперименты показали, что погрешность калибровки увеличения может достигать величины (0.6 – 0.8)%, если нелинейность оказывается на уровне 5%.
Смешное обстоятельство состоит в том, что измерительный SEM, которым до недавнего времени пользовалось головное учреждение правительства США – Институт Стандартов и Технологии (NIST) имел рекордную нелинейность разверток – 11%!
Еще один источник погрешности калибровки увеличения связан со свойствами эталона (стандарта), используемого для этих целей.
2.1.2. Стандарт для калибровки увеличения.
Выбор типа стандарта для калибровки далеко не безразличен. Существуют по крайней мере два типа эталонов (стандартов) длины: Стандарты «ширины линий» (Line Width Standards) и стандарты периода (pitch Standards). По общему признанию последние предпочтительнее для калибровки, из-за того, что калибровочным размером в данном случае служит период решетки, который удается определять различными способами, но без необходимости решать главную проблему размерной метрологии – проблему локализации края объекта на его увеличенном и неизбежно искаженном SEM-изображении. Более того, аттестация стандарта такого типа – дифракционной решетки (ДР) – может производиться независимым оптико-гониометрическим способом с высокой точностью и в абсолютной шкале размеров. Если бы все штрихи дифракционной решетки были бы одинаковы, а расстояния между ними – строго постоянными, то на пути использования подобных стандартов препятствий не было бы. К сожалению, все «рукотворные» изделия такого рода не отвечают этим требованиям. Проведенные тщательные измерения различных решеточных стандартов (NIST USA, HITACHI, Япония и др.) показали, что неоднородность периода обычно составляет 1.0 – 1.5% (3σ). Т.о. широко распространенное представление об однородности периода ДР является еще одной упрощающей идеализацией, и также не соответствует действительности. Т.о. погрешности, обусловленные остаточной нелинейностью разверток микроскопа, складываясь с погрешностями из-за неоднородности периода ДР, и с влиянием других факторов (например, неизбежных шумов видеосигнала), препятствуют проведению прецизионной калибровки увеличения SEM.
2.2. Погрешности, обусловленные несовершенством измерительных процедур. Левая ветвь рисунка 1.
2.2.1. Специфика измерений размеров в микроэлектронной технологии.
Особенностью измерений размеров в микроэлектронике является то, что по ряду существенных причин целесообразнее измерять размеры элементов схем на стадии формирования фоторезистивной маски. Поэтому типичными и наиболее важными объектами контроля оказываются рельефные детали фоторезистивной маски – полоски (линии) и контактные окна, сформированные в слое фоторезиста методами литографии, и имеющие в сечении трапецеидальную, либо прямоугольную форму.
Типичный вид SEM-видеосигнала S(x) (одна строка) от рельефной полоски с трапецеидальным сечением представлен на рисунке 3.
Наиболее существенными размерами таких объектов служат размеры, измеренные по нижнему срезу их трапецеидального сечения.
Важно подчеркнуть, что нижним кромкам трапеции соответствуют точки на наружных склонах максимумов видеосигнала, что и создает трудности локализации края при проведении измерений. Локализация краев объекта на его изображениях остается центральной проблемой измерений в любом виде микроскопии, т.к. размер любого объекта по определению – есть расстояние между его краями.
Для устранения влияния оператора на результаты измерений в современных SEM-измерителях (Hitachi серий 7000, 8000, 9000 и др., а также JEOL, KLA, AMAT, LEO) используются автоматизированные алгоритмы. Тем самым исключается главный источник невоспроизводимости – влияние оператора. Однако, среди известных и широко используемых алгоритмов, таких, как Threshold (T), Linear Approximation (LA), Curvature (CU), Derivative (DE), Fermi-Dirac(FD) – не существует таких, в основе которых лежат физически обоснованные представления о механизмах формирования видеосигнала в SEM. Недостаточно разработанная теория формирования видеосигнала не позволяет установить правила отыскания фактического положения тех точек на склонах видеосигнала, которые соответствуют краям измеряемого объекта. Вдобавок к этому, соответствующие программные реализации известных алгоритмов содержат параметры (степени свободы), устанавливаемые пользователем – оператором, полевым инженером, либо администратором по его собственному усмотрению, сообразуясь с интуицией и опытом. Заметим, что не существует никаких правил выбора значений свободных параметров.
Таким образом, в процедуру измерения размеров вновь получил доступ пресловутый «человеческий фактор».
Ниже приводятся результаты анализа возможностей распространенных алгоритмов Threshold и Linear Approximation, в программной реализации которых имеются несколько свободных параметров. Все выводы, следующие из этого анализа, кроме числовых оценок, можно распространить и на другие упомянутые выше алгоритмы, также содержащие свободные параметры.
2.2.2. Сравнительный анализ алгоритмов измерений.
При проведении анализа во всех случаях объектом измерений служило одно и то же исходное SEM-изображение (кадр), полученный на микроскопе Hitachi 4700 при ускоряющем напряжении 1.0 kV, увеличении 100000, отношении сигнал/шум 4. Использовалось 400 строк кадра, усредненных в одну строку. Ее вид показан на рисунке 3. Номинальный размер полоски по нижнему срезу ее сечения – 84.3 нанометра.
2.2.2.1. Алгоритм Threshold.
Этот алгоритм имеет два свободных параметра: сглаживание – Smoothing (S) и уровень отсечки видеосигнала – Threshold (T). Результаты измерений размеров L по одному и тому же видеосигналу, представленному на рисунке 3, отображены на рисунке 4 в виде поверхности L = f(S,T), передающей зависимость размера L от значений свободных параметров S и T.
Видно, что результаты измерений одного и того же объекта действительно варьируют в широком диапазоне в зависимости от значений указанных параметров. Ширина «коридора» возможных результатов для алгоритма Threshold достигает 50 и более нанометров.
2.2.2.2. Алгоритм Linear Approximation (LA).
Измерения размеров проводилось по тому же самому исходному изображению, но с помощью алгоритма LA. Особенностью этого алгоритма является то, что в его реализации предусмотрено наличие четырех (!) свободных параметров. Это обстоятельство не позволяет представить результаты измерений в виде столь же наглядной диаграммы, как рисунок 4. Анализ множества числовых данных, полученных в ходе измерений, позволяет заключить, что коридор возможных результатов и в этом случае простирается на многие десятки нанометров (около 80 нм при умеренных вариациях свободных параметров).
3. Обсуждение результатов.
Существует несколько причин столь низкой достоверности измерительных результатов. Проблема свободных параметров очерчена выше. Можно перечислить еще 5 – 6 причин, приводящих к столь недостоверным результатам. Это и влияние шумов видеосигнала, и остаточная нелинейность разверток, проявляющаяся в ходе собственно измерений, а не только при калибровке увеличения, это и т.н. «скрытые» свободные параметры, и некоторые другие причины. Их объединяет то, что даже сейчас видны решения, позволяющие существенно снизить влияние этих источников погрешностей.
Однако, существует и иные, глубинные причины низкой достоверности измерений. Они уходят корнями в недостаточную разработанность теории формирования видеосигнала в SEM. В частности, не найдены решения проблемы локализации края объекта на его SEM-изображении. Но практические нужды промышленности не могут ждать, индустрия требует решений сегодня, сейчас, пусть и не слишком бесспорных. Итогом такого вынужденного компромисса стало то, что на рынке появилось множество моделей измерительных микроскопов, оснащенных алгоритмами и программами измерений, метрологически несостоятельными. Фактически при использовании известных алгоритмов измеряется не размер физического объекта, но лишь расстояние между специальными точками на видеосигнале, фиксируемыми по тем или иным формальным математическим признакам, но вне какой бы то ни было связи с действительным размеров объекта.
Таков главный вывод о нынешнем состоянии микроэлектронной метрологии.
Можно ли удивляться тому, что в ходе сопоставительных измерений одного и того же объекта на разных микроскопах различными операторами – обнаруживаются недопустимо большие расхождения, достигающие нескольких десятков нанометров?4. Проблема Matching
Расхождения результатов измерений, проведенных на разных микроскопах, принято корректировать системой поправок, вычисляемых в ходе сопоставительных измерений (Matching). Практически эта процедура включает: выбор одного из имеющихся микроскопов и объявлению его образцовым – «золотым». Далее специальная служба организует сопоставительные измерения некоего образцового «золотого» объекта на образцовом и остальных микроскопах. По результатам таких сопоставительных измерений формируются таблицы коэффициентов перехода от результатов каждого микроскопа к результатам «золотого». Строятся и анализируются графики соответствия, (зависимость коэффициентов перехода от номинального размера), определяются точки пересечения этих графиков с осью Y, что определяет т.н. offset. Изучаются отклонения градуировочных графиков от линейных зависимостей и вводится «коэффициент нелинейности» для каждого микроскопа. Все таблицы соответствия и графики приходится периодически обновлять из-за процессов старения измерителей и дрейфа их характеристик. Для этих процедур на предприятиях содержится специальные службы. Такая вот деятельность. И она происходит на каждой фирме независимо от других. Т.о. у каждой крупной микроэлектронной фирмы образуется своя собственная система единиц, где нет места Парижскому Метру. Назад к волосатым предкам? Фантастика! Но факт.
При этом многие специалисты понимают, что если в результате измерений мы получали бы действительные размеры физических объектов, то результаты измерений совпадали бы автоматически, независимо от модели микроскопа, его характеристик и предпочтений оператора. А процедура Matching не потребовалась бы вовсе. Поэтому признание необходимости этой процедуры есть фактически всегда признание несостоятельности алгоритмов измерения.
В том виде, как это практикуется сегодня, процедура Matching представляется деятельностью, в ходе которой один неверный результат сложной системой поправок приводится к другому – столь же ошибочному.
В результате проведения процедур Matching не обеспечивается краеугольный принцип метрологии – принцип единства измерений; он заменяется другим принципом – единства измерительных ошибок, и то только в пределах одного предприятия, либо цеха (участка).
5. Воспроизводимость результатов измерений и их точность
До последнего времени в практике размерной метрологии, ориентированной на нужды микроэлектроники, понятие абсолютной точности (ACCURACY) встречалось крайне редко. Это обстоятельство находится в русле общепринятой, устоявшейся “методологии” измерений, согласно которой достаточно обеспечить воспроизводимость, (PRECISION) измерительных результатов, чтобы удовлетворить практическим нуждам микроэлектронной технологии. При этом считается, что возможное наличие систематических погрешностей, свойственных индивидуальным измерительным CD SEM или алгоритмам, вполне компенсируется процедурами MATCHING. Логика адептов такой методологии обычно аргументируется следующим образом.
Что из того, что при измерениях например, 50-нанометрового объекта А мы постоянно будем получать иное значение, скажем, 53 нанометра? Важно, чтобы это – пусть ошибочное – значение 53 нанометра обеспечивалось при любых повторных измерениях, а разброс измерительных результатов был бы минимальным.
Если эти условие выполняются, то, получив при измерении неизвестного объекта Б результат, скажем, 55 нанометров, мы можем быть уверены, что размер объекта Б на 2 нанометра больше, чем размер А.
Т.о. наличие систематической погрешности измерений (или недостаточная абсолютная точность) не препятствует проведению достоверных сопоставительных измерений. Является ли господствующая “методология” бесспорной?
Уточним, что основной целью измерения размеров в микроэлектронной технологии на промежуточных операциях по ходу изготовления конечного продукта (in-process measurement) является получение информации, позволяющей признать контролируемую пластину годной, либо подлежащей списанию в брак. Каждое проведенное измерение на пластине склоняет чашу весов в ту или иную сторону в зависимости от того, находится ли результат этого измерения внутри или вне заранее установленных пределов. Как правило, в качестве полуширины коридора приемлемых размеров, (допуска, tolerance) выбирается доля (10%) номинального размера (проектной нормы, NODE).
Так, в соответствии с ROADMAP [1] для микросхем с NODE 65 нм установлен допуск на размеры B=6.6 нанометров. Это означает, что, если измеренный размер заключен между пограничными значениями 58.4 и 71.6 нанометров, то этот факт служит аргументом в пользу признания изделия годным. Ниже для краткости такие результаты назовем «позитивными». Если же результат измерения лежит вне указанного диапазона, тогда он является аргументом для забракования пластины. («негативные» результаты). Баланс “позитивных” и «негативных» результатов измерений определяет, в конечном счете, дальнейшую судьбу контролируемой пластины: продолжит ли она движение по маршруту изготовления продукции, либо будет отправлена в корзину для брака. Совершенно очевидно, что обоснованность решений о забраковании модулей или пластин напрямую зависит от достоверности измерительных результатов. Необоснованное решение этого вопроса чревато существенными финансовыми потерями за счет снижения выхода годных изделий.
Проведенный анализ [2] показал, что в идеализированном случае, реализующимся при отсутствии систематической погрешности измерений Δ, при номинальном размере L0 = 65 nm, допуске на размер B = 6.6 nm, и среднеквадратичном разбросе результатов σ =1.7 нм – доля позитивных результатов составит 99,99%, а доля негативных – 0.01%, что выглядит вполне приемлемым.
Но при тех же значениях L0, B , и σ, и при наличии систематической погрешности измерений Δ=3 нм – доля позитивных результатов составит только 96,6%, а доля негативных – 3.4%. Т.о. доля негативных результатов возрастает в 340 раз!
Это, конечно, не может не сказаться на выходе годных изделий. Это и есть та плата, которую нынешняя промышленность буквально платит за пренебрежение абсолютными измерениями.
Проведены расчеты и для иных значений проектных норм: 45 и 32 нанометра. Из расчетов следует, что по мере уменьшения номинальных размеров, и, соответственно – допусков B – влияние погрешностей Δ резко возрастает. Так, если положить, что с течением времени проектные нормы уменьшатся настолько, что соответствующие значения допусков В станут соизмеримыми с систематической погрешностью Δ, то это приведет к потере половины положительных результатов измерений в целом. Другими словами, доля результатов, свидетельствующих в пользу забракования изделия, достигнет 50%. Понятно, что в подобных условиях разбраковка изделий на «годные» и «брак» – теряет всякий смысл.
Общий итог этого раздела можно сформулировать следующим образом:
Заключения о целесообразности признать изделие годным либо браком, либо выводы о необходимости корректировки технологии, сделанные на основе относительных измерений, всегда приводят к неоправданному снижению выхода годных, и это становится все более существенным фактором по мере освоения изделий с уменьшающимися проектными нормами 45 нм, 32 нм и менее.
Проведенный анализ состояния микроэлектронной метрологии стал возможен благодаря систематическому исследованию практики SEM-измерений на нескольких ведущих фирмах США, а также и других стран – по литературным источникам. Основным инструментом анализа стала оригинальная математическая модель формирования изображений (видеосигнала) в сканирующих измерительных микроскопах.[3] Выводы из этой модели легли в основу практических методов (частично защищенных патентами США) калибровки измерителей и проведения собственно измерений. Предложенные новые алгоритмы измерений не содержат «свободных параметров», а их опробование показало не только хорошую воспроизводимость результатов, но, при испытаниях на эталонных объектах (стандартах) – и минимальные систематические погрешности. Так, расхождение измеренных значений при опробовании наших методов на стандарте с номиналом 45.1 нм составило 0.2 нм, что сопоставимо с погрешностью аттестации самого этого стандарта.
Работы по дальнейшему совершенствованию методов измерений продолжаются.
Часть II
Проведенный анализ состояния метрологических проблем микро – и нано – технологии позволил выработать ряд технических решений, улучшающих возможности достоверных измерений. Эти решения касаются методов прецизионной калибровки увеличения, способов аттестации микроскопов по остаточной нелинейности разверток, а калибровочных решетчатых стандартов – по однородности из периода. Предложены и частично опробованы новые алгоритмы локализации края и на этой основе – новые методы измерений, не имеющие свободных параметров. При «слепых» испытаниях наших методов, на стандартах, когда авторы не знали заранее паспортных значений размера (номиналы 45 и 70 нм), получены расхождения в десятые доли нанометра, что сопоставимо с погрешностью их паспортных значений.
В совокупности эти и другие предложенные технические решения образуют целостную технологию измерений размеров в нанометровом диапазоне, пригодную для ее использования в условиях промышленного производства микроэлектронных изделий. Многие из них защищены патентами США , число которых превышает полтора десятка.
Литература.
- International Technology Roadmap for Semiconductors, (ITRS), SIA.
- A.V.Nikitin,D.Y.Yeremin, M..Sandy “ The importance of accuracy in SEM metrology”,Proc. Of SPIE, Vol. 6922, 154, (2008)
- A. Nikitin, A Sichignano, D. Yeremin at al., “Defining the role of SEM metrology for advanced process control”, Proc. of SPIE, Vol. 6152, 140, (2006).

Рис. 1. Схема проведения измерений критических размеров

Рисунок 2. Баланс измерительных погрешностей

Рисунок 3. Форма видеосигнала от фоторезистивной полоски.
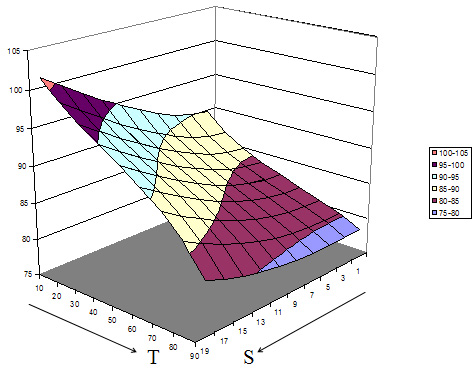
Рисунок 4. Зависимость измеренного размера (вертикальная ось) от свободных параметров S и T.Алгоритм Threshold.
- Войдите на сайт для отправки комментариев
 Сайт о нанотехнологиях #1 в России
Сайт о нанотехнологиях #1 в России